

如今越來越多的IC封裝基板/ PCB系統設計需要進行熱分析。 功耗是封裝/ PCB系統設計中的關鍵問題,需要仔細考慮熱和電兩個領域的問題。 為了更好地理解熱分析,我們以固體中的熱傳導為例,并利用兩個領域的對偶性。 圖1和表1描述了電域與熱域之間的基本關系。
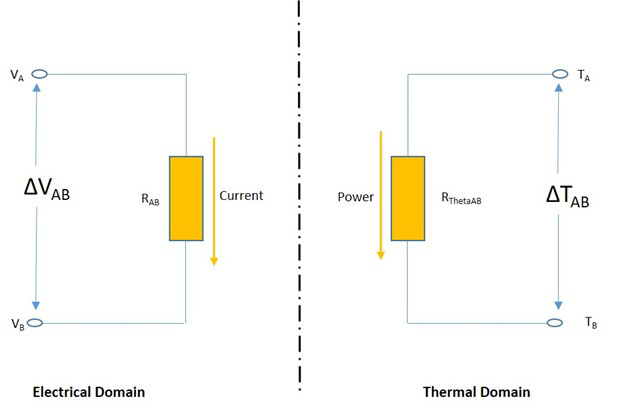
圖1. 電域與熱域之間的基本關系(點擊查看大圖)

表1. 電域與熱域之間的基本關系(點擊查看大圖)
電域與熱域之間存在一些差異,比如:
在電域,電流被限制在特定電路元件內流動,但在熱域中,熱流通過三種熱傳導機制(傳導、對流和輻射)在三維空間從熱源散發出去
元件之間的熱耦合比電耦合更加明顯且難以分離
測量工具不同。 對于熱分析,紅外熱像儀和熱電偶取代了示波器和電壓探頭
當固體或靜止流體介質中存在溫度梯度時發生熱傳導。 熱對流和熱輻射是比熱傳導更復雜的熱傳輸機制。 熱對流發生在固體表面與不同溫度流體材料接觸時。 熱輻射來自于所有溫度大于絕對零度的物質的電磁輻射。 圖2顯示了三種熱傳輸工作圖。 所有上述熱傳輸機制的一維應用的描述性等式如表2所示。
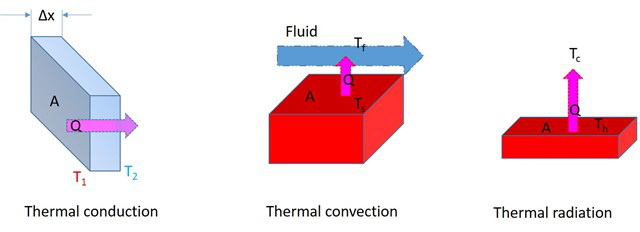
圖2. 三種熱傳輸機制(點擊查看大圖)

表2. 不同熱傳輸模式的方程(點擊查看大圖)
其中:
Q為每秒傳輸的熱量(J/s)
k為導熱系數(W/(K.m))
A為物體的截面積(m2)
ΔT為溫差
Δx為材料厚度
hc 為對流傳熱系數
hr 為輻射傳熱系數
T1 為一側的初始溫度
T2 為另一側的溫度
Ts 為固體表面的溫度(oC)
Tf 為流體的平均溫度(oC)
Th 為熱端溫度(K)
Tc 為冷端溫度 (K)
ε為物體的輻射系數(對于黑體)(0~1)
σ為Stefan-Boltzmann常數=5.6703*10-8 (W/(m2K4))
SigrityTM?PowerDCTM 是一種經過驗證的電熱技術,多年來一直應用于設計、分析及驗收封裝和PCB。 集成的電/熱協同仿真功能可幫助用戶輕松確認設計是否符合指定的電壓和溫度閾值,而無需花費大量精力從很多難以判斷的影響因子中進行篩選。 借助這項技術,您可以獲得準確的設計余量并降低設計的制造成本。 下圖展示了PowerDC用于電/熱協同仿真的方法:

圖3. PowerDC電/熱協同仿真方案(點擊查看大圖)
除了電/熱協同仿真,PowerDC還提供了其他與熱相關的功能,比如:
熱模型提取(圖4)
熱應力分析(圖5)
多板分析(圖6)
芯片封裝電路板協同仿真(圖7)
借助這些技術和功能,您可以方便快捷地通過圖示、量化來評估封裝或印刷電路板設計的熱流及熱輻射。

圖4. 封裝熱模型提取(點擊查看大圖)

圖5. 封裝熱應力分析示例(點擊查看大圖)

圖6. 多板熱分析(點擊查看大圖)

圖7. 使用Voltus-PowerDC進行芯片-封裝的熱協同仿真(點擊查看大圖)