

MEMS(微型機電系統) 麥克風是基于MEMS技術制造的麥克風,簡單的說就是一個電容器集成在微硅晶片上,使用表貼工藝貼裝到電路板上并搭配合適的ASIC,最后進行蓋外殼完成封裝。如下圖片為典型MEMS麥克風封裝結構。MEMS麥克風相比于傳統的ECM麥克風有以下優勢:a.可表面貼裝,全自動化生產,生產效率高,產品性能一直性好;b.能夠承受250℃以上的回流焊溫度,工作濕度與工作溫度范圍均大于ECM麥克風;c.并具有改進的噪聲消除性能與良好的 RF 及 EMI 抑制能。
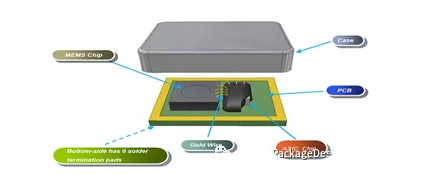
MEMS麥克風封裝物料主要包括MEMS芯片,ASIC芯片,PCB基板,金屬外殼,MEMS芯片粘貼與ASIC包覆的硅膠,ASIC芯片粘貼的環氧膠,電路連通用金線,金屬外殼與PCB基板焊接用錫膏。如下為MEMS麥克風封裝物料圖片。需要注意的是由于MEMS芯片的特殊結構需要特別注意粘片膠水的選型即關注澆水的硬度與楊氏模量,保證MEMS芯片有較低的應力,避免由于封裝帶入的應力影響MEMS麥克風的靈敏度。

MEMS芯片的結構決定了MEMS芯片封裝必將是差異化的封裝,一款產品將對應一種類型的封裝,所以沒有哪一家公司能夠對所有MEMS傳感器封裝完全通吃,MEMS麥克風的封裝工藝流程主要包括:芯片粘貼,金絲焊線,點涂膠保護芯片,外殼焊接,激光打標,劃片,包裝等工序。封裝流程如下圖所示。在此需要特別說明的是由于MEMS麥克風獨特的膜結構導致環境異物對產品的性能影響較大,封裝制程中,包括人體都是粉塵或者異物的攜帶者,非常容易污染芯片故,完成封裝需要在千級凈化車間進行,并嚴格規定車間作業人員的數量。