

目前是由著復雜的電路設計而成,而將這復雜的電路設計成耍弄的核心板離不開多層線路板(MLB)制造技術。
多層線路板(MLB)制造技術的發(fā)展速度飛快,特別是80時期后期,隨著高密度I/O(輸入/輸出)引線數(shù)量增加的VLSI,ULSI集成電路,SMD器件的出現(xiàn)與發(fā)展,SMT的采用,促使多層板的制造技術達到很高的工藝水平。還將隨著“輕,薄,短,小”的元器件被大量的廣泛應用,SMD的高速發(fā)展和SMT普及化,互連技術更加復雜化,促使多層板制造技術向精確精細周密線寬與窄間距,薄型高層化,微小孔徑化方向發(fā)展。多層印制電路板技術的轉化,即多層印制電路板制造技術已廣泛用于民用電器。
MLB的發(fā)展根據(jù)應用范圍的不同,普通分為兩大類別:一類是作為電子整機的基礎零部件,用于安裝電子元器件和進行互聯(lián)的基板;另一類是用于各類芯片和集成電路芯片的載板。用作載板的MLB導電圖形更為精確精細周密,基材的性能要求更為嚴肅而公正,制造技術也較為復雜。
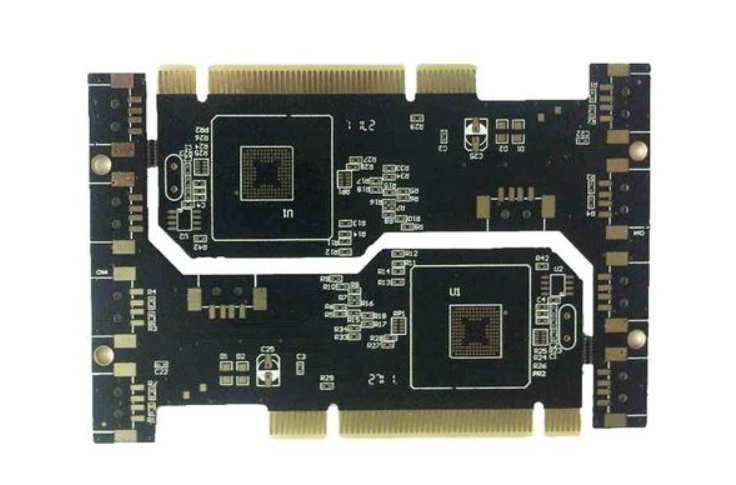
①、的高密度化
多層線路板的高密度化就意味著采用高精確精細周密導線技術,微小孔徑技術和窄環(huán)寬或無環(huán)寬等技術,是印制板的組裝密度大大提高。多層線路板高密度互聯(lián)技術基本狀況見下表(表2-1):
②、高精確精細周密導線技術
高密度互連署構的積層多層線路板,所采用的電路圖形需要高精確精細周密導線的線寬與間距介于0.05-0.15毫米之間。相應的制造工藝與裝備要具有形成高精度,高密度細線條的工藝技術和加工能力。
③、微小孔徑化技術
隨著多層線路板孔徑的縮小,對鉆孔工藝裝備提出更高的技術要求,同時需要采用全化學電鍍,直接電鍍技術來解決小孔電鍍附著力和延展性等問題。
④、核心板的縮小孔的環(huán)寬尺寸
空四四周圍環(huán)寬尺寸的縮小,可增加布線空間,因而進一步提高了多層線路板的電路圖形密度。
⑤、多層線路板結構多樣化
隨著非常準確器件的高穩(wěn)定性,高可靠性要求,多層線路板制造的密度要求和互聯(lián)數(shù)量與復雜化的增加,其結構的多樣化在所難免。
⑥、薄型多層化技術
薄型多層化的技術完全適應元器件“輕,薄,短,小”和高密度化的技術要求。當前多層線路板的制造工藝技術發(fā)展趨勢分為:高層薄型板和平常的薄型板。高層薄型多層線路板的厚度將為0.6-5.0MM,層數(shù)從12-50層或更高;薄型多層線路板厚度將為0.3-1.2MM,層數(shù)從4-10層或更高。
⑦、埋,盲和通孔相結合多層板制造技術
這種類型的多層印制線路板結構復雜,將使用大量的電氣互連技術解決,因而可提高布線密度達50百分之百,大大減少對精確精細周密導線,微小孔徑的環(huán)寬制作的壓力。
⑧、多層布線多層線路板
多層布線多層線路板的結構是在無銅箔基板表面涂有粘結劑,然后利用計算機輔助提供的數(shù)字控制布線機,將0.06-0.1MM的方形漆包線按X,Y方向,互相垂直縱橫布線,再以45°斜向布線,分別布設在基板的兩面上,布線完成后用薄膜覆蓋起來,起到固定和保護作用,在進行固化,進行數(shù)控鉆孔加工等工序。
⑨、直寫式技術
采用直寫式技術能完全的,迅疾的生產(chǎn)出樣機(即自由形成三維制造,激光燒結,金屬印刷技術等)使其通過三維結構和生產(chǎn)出有特性的樣機。
直寫式有利的方面就是它的范圍比較寬,能夠對電子系統(tǒng)的制造具有沖擊力。